刘益春院士团队李炳生教授MOCVD课题组研究论文---引入GaON成核层实现β-Ga₂O₃/GaN高性能紫外探测器
由集成光电子全国重点实验室东北师范大学的研究团队在学术期刊 Materials Today Physics 发布了一篇名为 Enhanced performance UV photodetectors based on the β-Ga2O3/GaN photodiode of the reversed substitution growth with introduction nucleation layer of GaON by oxygen plasma treatment(通过氧等离子体处理引入 GaON 成核层进行反向替代生长,增强基于 β-Ga2O3/GaN 光电二极管紫外光电探测器的性能)的文章。
1. 项目支持
本研究得到了国家自然科学基金(62274027和62404039)、宽带隙光电子材料与器件集成学科创新引智基地(B25030)松山湖材料实验室开放研究基金(2023SLABFK03)和吉林省(20220502002GH)、CPSF博士后科研流动项目(GZC20230416)以及中央高校基本科研业务费专项资金(2412024QD010)的支持。
2. 背景
β-Ga2O3 因高吸收系数及紫外区域的高效光子吸收成为理想紫外光电探测器材料。为提升光电转换效率,常通过构建异质结以促进载流子分离与传输。其中,β-Ga2O3/GaN异质结得益于两者间的较小晶格失配而备受关注。传统外延 n-β-Ga2O3/p-GaN 异质结因界面势垒阻碍载流子输运并降低检测效率。而反向替代法因高温氧化速度过快易造成表面热损伤。本研究提出氧等离子体处理(OPT)辅助反向替代法,在 GaN 表面预先形成 GaON 成核层。并系统的研究了GaON 层对后续氧化的性能影响。
3. 文章摘要
展示了一种具有偏压可调光谱响应(UVC 波段到 UVA-UVC波段)的高性能 β-Ga2O3/GaN 紫外光电探测器。该器件是通过一种新的反向替代生长路线制造的,通过 OPT 在 GaN 表面引入 GaON 成核层,用于 β-Ga2O3 合成。详细分析了成核层对 GaN 在氧气环境下高温转化为 β-Ga2O3 的影响。X 射线衍射(XRD)证实,形成了具有窄线宽的(-201)择优取向单斜相 β-Ga2O3。X射线光电子能谱(XPS)和原子力显微镜(AFM)证实,经OPT处理的 β-Ga2O3 表面上的氧空位(VO)和表面粗糙度的均方根(RMS)都降低了,从而与电极形成了更好的界面接触。同时,内部 VO 的增加增强了材料的导电性,从而提高了光电响应性能。金属半导体金属(MSM)器件实现了超高的探测能力(响应度= 653 A/W,探测率= 2.9×1015 Jones),并通过改变施加的偏压在日盲窄带和 UVA-UVC 宽带之间切换响应光谱。瞬态响应时间以毫秒为单位。在垂直型 β-Ga2O3/GaN 光电二极管中,在 -10 V 的偏压下,光电探测器的响应度和探测率达到 2.1 A/W 和 7.2×1013 Jones,瞬态响应时间快(上升时间=0.24 ms,衰减时间=17.1 ms)。
4. 创新点
•使用反向替代法,残留的氮(作为受体)导致所得 Ga2O3 中的费米能级低于 GaN。改变光生载流子的输运方向,有助于避免能带偏移的界面势垒。
•OPT 辅助反向替代法,在热氧化前引入 GaON 成核层,降低氧化速率。
•有效控制了 β-Ga2O3 中的氧空位,减少了表面缺陷,提高了材料的导电性。
•通过控制施加的偏压,实现了从 UVC 波段到 UVA-UVC 波段的可调谐检测。
5. 结论
在这项研究中,β-Ga2O3 薄膜在GaN上成功地进行了热氧化。通过调节施加的偏压的大小,实现了从 UVC 到 UVC-UVA 波段的可调检测。此外,通过 OPT 引入 GaON 的方法降低了 β-Ga2O3 的表面粗糙度,有效地控制了表面和内部的氧空位。在提高样品电导率的同时,表面缺陷状态也得到了改善。MSM 型 β-Ga2O3/GaN 异质结光电探测器的响应度在 10 V 下从 79 A/W 显著提高到 653 A/W。同时,瞬态响应速度得到了提高,上升/衰减时间分别为 0.29 ms/68 ms。此外,垂直型器件得到了进一步优化,实现了 0.24 ms 的上升时间和 17 ms 的衰减时间。这项研究为提高紫外光电探测器的性能提供了一种实用的方法。
6. 图文内容

图1. Ga2O3 生长工艺流程图。

图2. Ga 3d 的 XPS 光谱:(a)未经 OPT 处理的 GaN 和 (b) 经过 OPT 处理的 GaN。(c)经过 OPT 处理的 GaN 原子排列分布示意图。

图3.(a) 样品 A(未经 OPT 处理的 GaN 氧化后的氧化镓)、样品B(经 OPT 处理的 GaN 氧化后的氧化镓)和 GaN 的 XRD 光谱。(b) 经过和未经过 OPT 的 GaN 的氧化生长速率。(c,d)扫描面积为 5μm×5μm 的样品 A 和样品 B 的AFM 图像。(e) 样品 A、样品 B 和 Ti 的 KPFM 和电位图。

图4. 样品 A 和样品 B 的 XPS 光谱:(a,b)Ga 3d;(c,d)O 1s;(e,f)Ar+ 蚀刻后的 Ga 3d;Ar+ 蚀刻后的(g,h)O 1s。
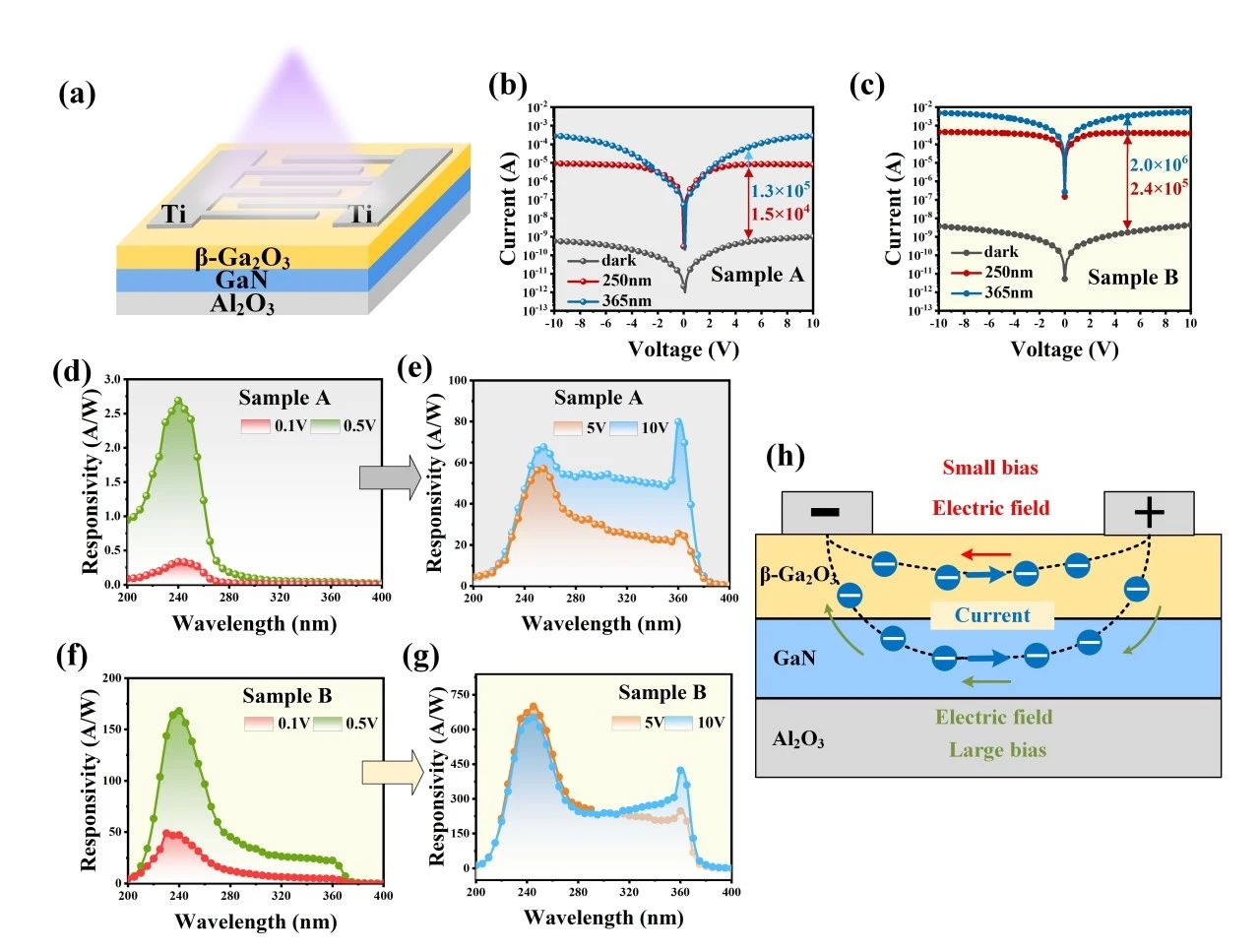
图5. 样品 A 和样品 B 的 MSM 型的 β-Ga2O3/GaN 紫外光电探测器的光电性能表征:(a)器件结构示意图。(b,c)I-V曲线。(d,f)低偏压下的响应度光谱。(e,g)高偏压下的响应度光谱。(h)电子输运图。
DOI:
doi.org/10.1016/j.mtphys.2025.101729
本文转发自《亚洲氧化镓联盟》订阅号
